ヘッドスペースガスクロマトグラフ質量分析法によるシリコーン系材料の低分子環状シロキサンの定性定量分析
なぜヘッドスペースガスクロマトグラフ質量分析法を用いるのか?
シリコーン系材料から発生する低分子環状シロキサンは電子部品の電気接点障害の原因となります。
低分子環状シロキサンは揮発性があり、リレースイッチなどの電子部品の接点部に付着し、接点開閉時のアーク等によって酸化分解され、二酸化ケイ素(SiO2)となって、これが蓄積すると導通性がとれなくなります。
ヘッドスペースガスクロマトグラフ質量分析(HS-GC/MS)法は試料を専用のバイアル瓶に入れ、密閉した後に設定した温度で加温します。試料から気化した成分をGC/MSで分析し、どういったガスがどれくらいの量揮発したかを調べる装置です。
シリコーン系材料をHS-GC/MSで分析することで、使用温度環境における低分子環状シロキサンの発生を調べることができます。
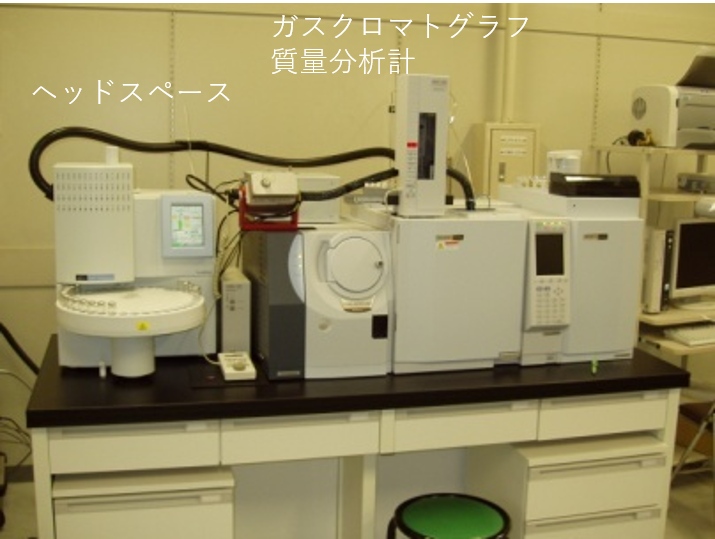

分析結果
150 ℃で30 分間シリコーン系材料を加温した時のHS-GC/MS結果を示します。D3は検出されませんでしたが、D4~D10が検出されました。これらの低分子環状シロキサンが検出されるシリコーン系材料の近くに電子部品がある場合は接点不良のリスクが高くなります。
定量の場合はD3~D6についてはそれぞれの標準試薬により定量値を求めますが、D7~D10については、D6による換算値となります。


ヘッドスペースによる加温可能な温度範囲は40 °C~180 °Cです。
サンプル形状は別途相談をお願いいたします。
ご利用を希望される方へ
このページのご紹介内容は、試験計測(依頼試験)でご利用いただけます。
料金表(単位欄にメーカー・型式を表記している場合:機器使用料金(特に記載がない限り単位は1時間あたり))| 料金NO. | 項目 | 単位(又はメーカー・型式) | 料金 |
|---|---|---|---|
| E2330 | ヘッドスペースGCMS分析 | 1試料1成分につき | 57,860円 |
| E2331 | ヘッドスペースGCMS分析 定性分析 1成分増 | 1成分増すごとに | 5,720円 |
| E2332 | ヘッドスペースGCMS分析 定量分析 1成分増 | 1成分増すごとに | 6,710円 |
関連リンク
- 試験計測(依頼試験):ヘッドスペースGCMS分析
ご活用いただける業種、分野等
今回のヘッドスペースガスクロマトグラフ質量分析法によるシリコーン系材料の低分子環状シロキサンの定性定量分析の事例については、
シリコーン系材料を取り扱うメーカー、販売業者電子機器メーカー、販売業者 の皆様におすすめです。
以下のようなお悩み・課題の解決にご活用ください。
・低分子環状シロキサンによる電子部品の接点不良対策
材料 高分子|技術分野 その他|分析・試験・評価法 組成成分
- この分析事例に関連するお問い合わせ
- 担当:化学技術部