LSIコンタクトホールの2方向観察事例
LSIに異常が確認され、断面観察よりコンタクトホール直下約50nmの箇所に微小欠陥を捉えることができました。
また、同箇所の平面観察を行い、微小欠陥を定量化しました。
<使用機器> FE-TEM/EDS(電界放出型透過電子顕微鏡)
FIB(集束イオンビーム装置)
低エネルギーイオンミリング
<測定手順>
・FIB-マイクロプロービング法による断面試料作製
↓
・低エネルギーイオンミリングによる薄片化
↓
・TEMによる断面観察(微小欠陥の位置を確認)
↓
・FIBによる平面試料作製
↓
・低エネルギーイオンミリングによる薄片化
↓
・ TEMによる平面観察(確認)
↓
・低エネルギーイオンミリングによる微小欠陥の抽出(複数回)
↓
・ TEMによる平面観察
<納 期> 担当職員にお問い合わせください。
測定例
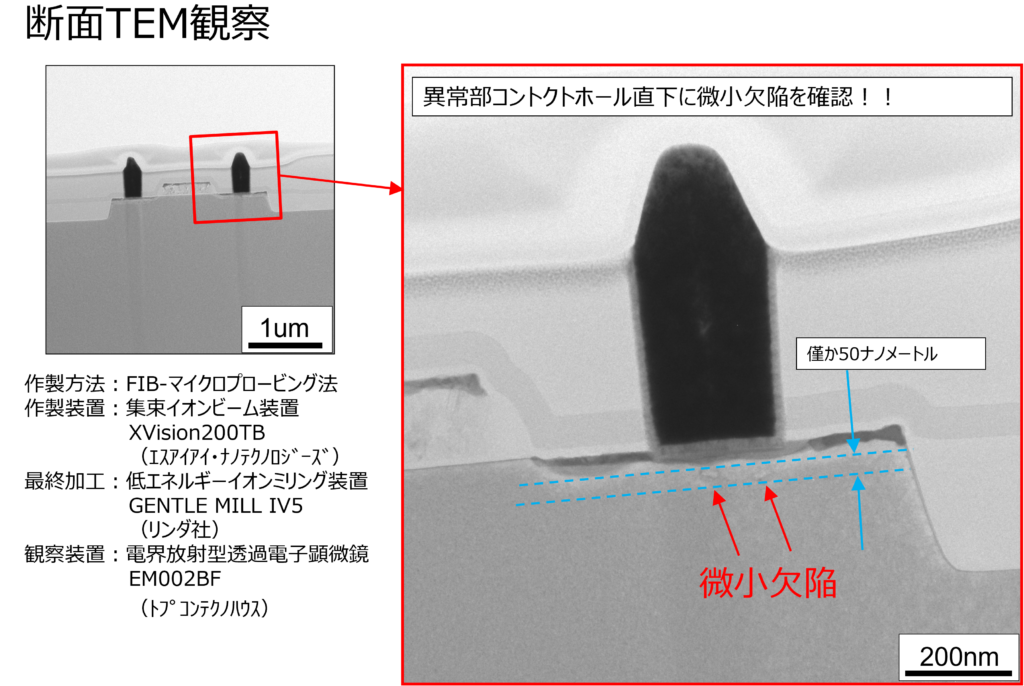
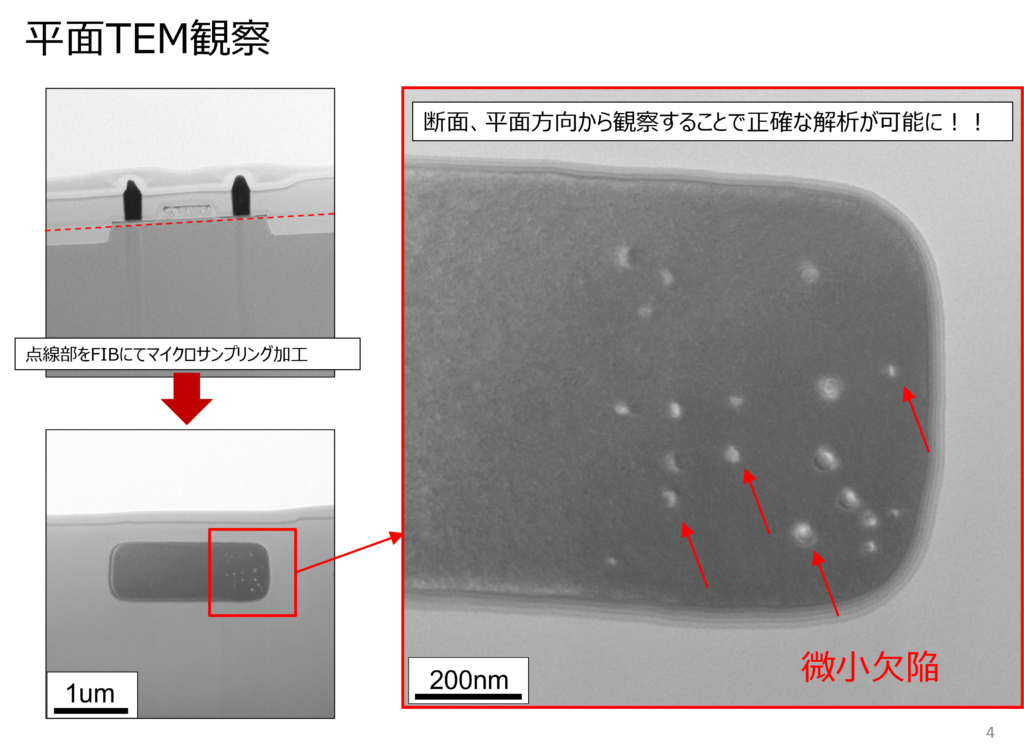
ご利用を希望される方へ
このページのご紹介内容は、試験計測(依頼試験)でご利用いただけます。
観察条件および撮影枚数により費用は変わりますので、詳細は担当職員にお問い合わせください。
ご要望に応じて見積書を作成いたします。
| 料金NO. | 項目 | 単位(又はメーカー・型式) | 料金 |
|---|---|---|---|
| K1625 | TEM試料調製 FIB-マイクロプロービング法 低加速ガリウムイオン | 低加速ガリウムイオン仕上げ 1試料につき | 122,100円 |
| K1425 | TEM試料調製 低エネルギーイオンミリング (ジェントルミル) | 1試料1条件につき | 14,850円 |
| K1440 | 電界放出型分析透過電子顕微鏡(FE-TEM)10万倍以下 | 倍率 10万倍以下 1視野につき | 19,470円 |
| K1441 | 電界放出型分析透過電子顕微鏡(FE-TEM)10万倍を超えて50万倍以下 | 倍率 10万倍を超えて50万倍以下 1視野につき | 25,850円 |
| K1460 | 電界放出型分析透過電子顕微鏡(FE-TEM)試料傾斜調整 | 試料傾斜調整 1条件ごとに | 13,420円 |
関連リンク
材料 電子材料|技術分野 不具合|分析・試験・評価法 微細構造
- この分析事例に関連するお問い合わせ
- 担当:川崎技術支援部